Focused Ion Beam
Die Untersuchungen an dem Ionenfeinstrahlmikroskop (engl. focused ion beam, FIB) stützen sich auf das Gerät SCIOS2 der Firma Thermo Fisher Scientific.
Diese Zweistrahlanlage (dual beam) – Kombination von Rasterelektronenmikroskop (REM) und Focused Ion Beam (FIB) – ermöglicht eine detaillierte Abbildung von Mikro- und Nanostrukturen, sowie präzise Strukturierung im Nanometerbereich.
Folgende Analyse- bzw. Modifikationsmöglichkeiten sind vorhanden:
- Abbildung der Mikrostruktur von Proben mittels Sekundär- (SE), rückgestreuten (BSE) oder transmittierten (TE) Elektronen
- Mikrostrukturierung der Proben: FIB-Querschnittspräparation zur Darstellung tiefliegender Strukturen und Ermittlung von Schichtdicken
- Herstellung von TEM-Lamellen, in-situ Transfer von fertigen Lamellen mittels Nanomanipulator
- Mikroabscheidung von Schutzschichten oder zur Kontaktenherstellung für Bauelemente
Es ist eine Erweiterung des Dual Beam Systems mit Kathodolumineszenz- und EBIC-Einheit für in-situ Messungen von optischen bzw. elektrischen Eigenschaften der Halbleiterstrukturen im Aufbau.
 |
Technische Daten: FIB-System
SEM-System
System
|
Anwendungsbeispiele (mit Bildergalerie)
Das FIB-System wird zur Aufklärung der Mikrostruktur von Halbleiterstrukturen sowie zur gezielten Modifizierung dieser Proben verwendet.
- Abbildende Untersuchungen auf mikroskopischem und submikroskopischem Niveau
- Schichtdickenmessung
- gezieltes Abscheiden von Platin
- gezielte Strukturierung von Proben
- Präparation von TEM-Lamellen
- In-situ STEM-Untersuchungen im REM
 |
 |
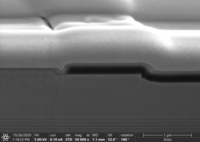 |
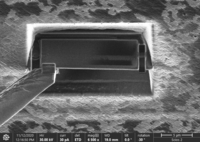 |
| REM-Aufnahme von Goldpartikeln | Gezieltes Ga-Ion-Ätzen | Querschnittspräparation | Präparierte TEM-Lamelle |




